Введение
С физикой тонких пленок связаны достижения и перспективы дальнейшего развития микроэлектроники, оптики, приборостроения и других отраслей новой техники. Успехи микроминиатюризации электронной аппаратуры стали возможны благодаря использованию управляемого эпитаксиального выращивания тонких слоев полупроводников, металлов и диэлектриков в вакууме из различных сред. Несмотря на многочисленные и разносторонние исследования, процессы эпитаксиальной кристаллизации не получили полного объяснения. Обусловлено это, в первую очередь, сложностью проблем связанных с процессами кристаллизации в различных системах и средах.
В последние годы наблюдается возрастание интереса к поверхности твердого тела. Экспериментальные достижения в этой области связаны с развитием техники сверх высокого вакуума, диагностической аппаратуры, такой как сканирующая туннельная микроскопия и разработкой новых спектроскопических методов исследования поверхности. Эти исследования обеспечили более глубокое проникновение в структуру и свойства поверхностных слоев твердого тела. Однако представления о структуре поверхности и влиянии ее на эпитаксиальный рост недостаточно развиты.
В данной работе исследуется эпитаксиальный рост простых полупроводников Siи Geна поверхности Si(111) методом анализа осцилляций зеркально-отраженного пучка при дифракции быстрых электронов.
Обзор литературы
Молекулярно-лучевая эпитаксия Siи Ge7
В начале 60-х с большим оптимизмом были начаты работы в области обработки поверхностей пластин кремния в вакууме, но через некоторое время исследователи этого направления утратили ведущие позиции, и в настоящее время интегральные схемы изготавливают на кремниевых пластинах методами химической обработки. Вместе с тем необходимость создания интегральных схем очень большой степени интеграции стала основной движущей силой для понижения температур обработки, и постепенно технологические приемы, связанные с физическими методами, проникают в технологические линии для изготовления кремниевых интегральных схем. В этом отношении выращивание кремниевых эпитаксиальных пленок приборного качества в условиях сверхвысокого вакуума (СВВ) явилось важным шагом вперед. Этот факт отражен в резком возрастании с тех пор числа публикаций по молекулярно лучевой эпитаксии (МЛЭ) кремния.
Высококачественный процесс послойного роста принципиально важен для производства материалов для электроники с помощью МЛЭ. Он привлекает к себе внимание благодаря ряду присущих ему преимуществ, таких как: его гибкость, обеспечение высокой чистоты, возможность ведения всего процесса производства в вакууме, применимость масок, допустимость существенного варьирования скорости роста и понижение температуры кристаллизации, быстрота перехода от осаждения одного полупроводника к другому.
Использование эпитаксиальной технологии в микроэлектронике требует устранения или сведения к минимуму протяженности переходных слоев между пленками в полупроводниковых структурах. Метод осаждения из газовой фазы путем химических реакций для Si/Siи Ge/Siимеет температурную область кристаллизации 800-1200°С[1]. При такой температуре существенны процессы объемной диффузии между материалом подложки и осаждаемым веществом, что ведет к размытию границы между ними. Характерные температуры осаждения Si/Siи Ge/Siдля получения эпитаксиальных пленок методом МЛЭ лежат в диапазоне 300-800 °С. Низкая температура МЛЭ кремния и германия достигается тем, что этот метод не требует ни плавления, ни химической реакции осаждения. В этих условиях влияние диффузии и автолегирования незначительно, а деформация во время роста минимальна. Благодаря этому стало возможным получение дельта слоев[2], резких границ в гетероструктурах и четких профилей легирования.
Поверхность Si(111)
Исследование процессов роста является важной проблемой МЛЭ, так как точное представление о механизмах происходящих процессов позволит управлять ими и создавать слои с воспроизводимыми характеристиками.
Благодаря большому количеству современных методик анализа поверхности таких, например, как дифракция медленных электронов (ДМЭ)[3], фотоэлектронная спектроскопия с угловым разрешением [4], просвечивающая электронная микроскопия и сканирующая туннельная микроскопия (СТМ)[5-7], позволили получить много полезной информации о строении поверхности и процессах роста.
Из-за взаимодействия оборванных связей, атомы в приповерхностной области стремятся перестроиться в более энергетически-выгодные положения, образуя на поверхности двумерную периодическую структуру. Природа и стабильность реконструированных поверхностей очень чувствительна к условиям приготовления образца. Так, поверхность скола Si(111) реконструируется в метастабильную структуру (2х1), которая при отжиге 380°С необратимо трансформируется в структуру (7х7)[8]. При температуре выше 830°С поверхность Si(111) имеет сверхструктуру (1x1) (не имеет сверхструктуры) [9], эта температура является точкой фазового перехода для поверхностной реконструкции Si(111).
Наиболее полную информацию о структуре и морфологии поверхности дает сканирующая туннельная микроскопия. Изображения поверхности, полученные этим методом, свидетельствуют о том, что в зависимости от способа приготовления образца, атомарно чистая поверхность Si(111) может содержать смесь нескольких сверхструктур. Так Y.-N. YangE.D. Williams[10] наблюдали, что для образца нагретого до 900°С и закаленного со скоростью 100К/сек., на поверхности Si(111) образуются помимо (7x7) сверхструктуры еще ряд метастабильных сверхструктур как (11x11),(9x9), (2x2),( 3x 3).
Говоря о поверхностных реконструкциях, имеется в виду двумерная периодичность на атомарно гладких частях поверхности. Реальная поверхность кремния далека от совершенной и содержит различные дефекты, такие как выходящие на поверхность кристалла дислокации, дефекты упаковки и загрязнения оставшиеся после предэпитаксиальной обработки.
Из-за неидеальности среза, поверхность реального кристалла, прошедшего соответствующие стадии обработки, состоит из чередующихся террас, разделенных ступенями атомной высоты. Авторы [12] получили изображения ступеней слабо разориентированной поверхности Si(111). Откуда видно, что такая поверхность представляет собой последовательность почти параллельных и в пределах порядка отличающихся друг от друга по ширине террас, разделенных ступенями монослойной высоты.
Эпитаксия Siна Si(111)
Эпитаксия Siна Si(111) методом МЛЭ изучена в широком диапазоне температур, от комнатной [13], до 1000°С. Температура эпитаксии выбирается в зависимости от требуемой структуры пленки (например аморфная или монокристаллическая) и необходимым уровнем легирования (т.к. коэффициент встраивание атомов легирующей примеси сильно зависит от температуры).
В зависимости от размеров террас, температуры поверхности и пересыщения, при послойном росте различают два механизма: ступенчато-слоевой и двумерно-островковый.
В случае роста по ступенчато-слоевому механизм все упавшие на поверхность атомы, не образуя островков, встраиваются в ступени либо десорбируют. Если же концентрация адатомов на поверхности достигает некоторого критического значения зависящего от температуры и ширины террас, то начнется образование двумерных островков (двумерно-островковый механизм). Плотность адатомов, вокруг существующих островков уменьшается за счет диффузии и встраивания адатомов в островок или ступень. И в некоторой зоне вокруг уже образовавшихся островков последующие критические зародыши образовываться не могут.
Рост идет в основном за счет разрастания двумерных зародышей.
При повышении температуры роста происходит увеличение размеров критических зародышей, средних расстояний между ними и зон истощения вокруг их и у ступеней [7,14]. Пропуская по пластине Si(111) электрический ток можно добиться значительного увеличения ширины террас (до нескольких микрон) из-за эшелонирования поверхности[15], вследствие чего температура перехода от двумерно-островкового к ступенчато-слоевому механизму сдвигается в более высокотемпературную область.
Исследования процессов зарождения двумерных островков на поверхности Si(111)-(7х7) показало, что зарождение островков происходит предпочтительно на границах сверхструктурных доменов [5-7]. В процессе роста, сверхструктура монослойного островка, образующегося на поверхности, может не соответствовать сверхструктуре подложки. U.Kohler[13], изучая процессы зарождения и роста Siна Si(111) методом СТМ обнаружил, что на идеальной поверхности Si(111)-(7x7) образовавшийся монослойный островок может иметь помимо (7x7) сверхструктуры, еще (5x5) и (9x9). В [16] используя ДМЭ, показано, что для Si(111) с разориентацией не хуже 0.05 градусов в процессе роста, после покрытия десятью монослоями на растущей поверхности в температурном диапазоне 650-870 К (380-600°C)присутствует смесь двух сверхструктур (5x5) и (7x7), а при температурах роста выше 870 К (600°C) наблюдается только сверхструктура (7x7). Причем интегральная интенсивность сверхструктурных рефлексов зависит от температуры строго определенным образом.
Исследования зарождения Siна почти идеальной поверхности Si(111)-(7х7) показало, что зарождение островков происходит предпочтительно на метастабильных реконструкциях и дефектах поверхности уже образовавшихся островков, поэтому на идеальной поверхности (7х7) второй монослой начинает образовываться задолго до завершения первого. Затем островки двумонослойной высоты срастаются, после чего идет обычный послойный рост.
Анализируя размеры и плотность островков в течении или после роста можно определить некоторые параметры поверхности, например, такие как энергию активации поверхностной диффузии. Однако значение этой энергии в разных работах колеблется от 0.5 до 2 эВ, но большинство авторов при моделировании и расчетах других энергетических параметров поверхности используют значение 1эВ.
В работе замечено что образование островков на поверхности Si(111) зависит от направления ступени, на которой зарождаются островки. Для ступеней с направлением зарождающиеся на поверхности островки располагаются примерно на равном расстоянии друг от друга и от края ступени. Для ступеней с направлением на верхней террасе ступени, зародившиеся у края ступени островки, не имеют зоны обеднения с этой ступенью (см. Рис.1). Отличие этих ступеней заключается в том, что для ступени атомы находящиеся в ступени имеют одну оборванную связь, а для ступени две оборванные связи.
Островки, зарождающиеся на террасах, всегда имеют направления сторон такие же, как для ступеней, т.е. атомы стоящие на краю островков имеют по две оборванные связи.

Рисунок 1 Зарождение островков на террасах с различными направлениями ступеней
Эпитаксия Geна Si(111)
Интерес к эпитаксии германия на кремнии обусловлен как с технологической, так и научно-исследовательской точек зрения. Например, изготовление GaAsфотоприемников на дешевых кремниевых подложках, из-за несоответствия их постоянных решеток требует переходного слоя. Получение бездефектных Geслоев может решить эту проблему, т.к. GaAsи Ge имеют близкие значения постоянных решеток (0.569нм и 0.566нм соответственно).
В настоящее время сильно возрос интерес к прямому получению низкоразмерных GeSi структур[19,20]. Так образование трехмерных островков, например германия на кремнии, в соответствии с механизмом роста Странского-Крастанова [21], может быть использовано для получения слоя квантовых точек. При создании таких структур важно знать процессы происходящие на поверхности в процессе роста.
Начальная стадия роста при комнатной температуре на поверхности Si(111)-(7х7) характеризуется встраиванием атомов Ge в ступени поверхности и зарождением двумерных островков предпочтительно на границах сверхструктурных доменов. Рост Geидет послойно до толщины пленки три монослоя, последующий низкотемпературный рост ведет к образованию аморфной пленки [22]. При температуре поверхности больше 350°C после третьего монослоя начинается образование трехмерных островков [7]. Остановка роста на трех монослоях и отжиг при температуре больше 300°C ведет к тому, что атомы германия из третьего монослоя переходят в срелаксированные островки[5].
Изучая гетероэпитаксиальный рост Geна Si(111) авторы [5] определили энергию активации поверхностной диффузии (1.2 эВ) и показали, что она не зависит от скорости роста в интервале скоростей 0.03-0.14 монослоя/сек.
Дифракция быстрых электронов
Дифракция быстрых электронов на отражение (ДБЭ) является распространенным методом анализа структуры поверхности пленок в процессе МЛЭ. Большое распространение этого метода связано с простотой использования методики и наличие большого свободного пространства перед образцом. Еще одним из преимуществ ДБЭ является то, что из-за большого различия по энергии между упруго рассеянными электронами и фоном неупругого рассеяния и достаточность энергии первичных электронов для возбуждения свечения люминесцирующего экрана, в ДБЭ (в отличие от дифракции медленных электронов) отсутствует необходимость тщательной энергетической фильтрации и повторном ускорении.
Кроме того, ДБЭ позволяет непрерывно следить за ростом эпитаксиальных пленок на поверхности, вследствие того, что фронтальная часть образца становится доступной для испаряющихся источников. Большой интерес к МЛЭ, как к способу выращивания материалов для полупроводниковых приборов, оказал стимулирующее воздействие на применение ДБЭ.
Помимо улучшенного доступа к поверхности, обеспечиваемого геометрией ДБЭ, по сравнению с ДМЭ, этот метод обладает и другими преимуществами при изучении эпитаксиального роста и процессов на многослойных поверхностях. В частности, использование падения с малыми углами скольжения делает этот метод чувствительным к микрорельефу поверхности. Если ДМЭ (обычно при нормальном падении) выделяет хорошо упорядоченные области поверхности с ориентацией, близкой к средней ориентации поверхности, то электроны при скользящем падении будут проникать в шероховатости на поверхности, если она является микроскопически гладкой. Очевидно, что это повышает требования к более тщательному приготовлению образцов для исследования методом ДБЭ, но в то же время означает, что этот метод может выявить изменения в морфологии поверхности. Например, если эпитаксиальный рост приводит к росту островков на поверхности, то картина скользящего отражения от плоской поверхности, которая наблюдалась в отсутствии островков, сменится картиной содержащей дифракционные рефлексы от трехмерных объектов. Это может использоваться, например, для определения критической толщины псевдоморфной пленки, и определения ориентаций граней островков[19].
С другой стороны, ДБЭ имеет определенные недостатки при изучении двумерно симметричных структур для случая микроскопически-гладкой поверхности. Например, для выявления полной двумерной периодичности, образец необходимо вращать вокруг нормали к поверхности. Изменение периодичности в плоскости падения не приводят к изменениям периодичности дифракционной картины.
Кроме анализа структуры поверхности пленок, регистрация осцилляций зеркально-отраженного пучка быстрых электронов от поверхности растущей пленки дает возможность измерять скорость роста пленок и контролировать их состав и толщину. Анализируя характер осцилляций можно изучать реализуемые механизмы роста, определять параметры поверхностной диффузии и встраивания адатомов [23].
Осцилляции интенсивности имеют место при реализации двумерно-слоевого роста. За счет периодического изменения шероховатости, интенсивность зеркального рефлекса осциллирует отслеживая гладкость поверхности. Однако с увеличением толщины пленки исходная поверхность с атомно-гладкими террасами трансформируется в поверхность со стационарной степенью шероховатости. Это в свою очередь ведет к затуханию амплитуды осцилляций. Первая причина такой трансформации заключается в том, что по мере роста пленки по двумерно-слоевому механизму, т.е. за счет образования и разрастания двумерных зародышей, двухуровневая поверхность, характерная для идеального двумерно-слоевого роста, становится многоуровневой. Вторая причина в десинхронизации зарождения двумерных зародышей на разных террасах. Используя регистрацию осцилляций, авторы [24] предложили идею синхронизации образования двухмерных зародышей, расширив тем самым возможности метода МЛЭ.
Амплитуда осцилляций и их форма зависят от азимута и угла падения электронного пучка, т.е. от так называемых дифракционных условий. В условиях резонанса дифрагированная волна претерпевает многократное отражение от атомных плоскостей параллельных поверхности и имеет максимальную чувствительность к морфологии поверхности, поэтому в условиях поверхностного резонанса осцилляции имеют максимальную амплитуду.
Авторы показали, что при гомоэпитаксии Siна Si(100) осцилляции интенсивности зависят от азимута падения электронного пучка. Для направления одна осцилляция зеркального рефлекса соответствует покрытию в один монослой, а для [110] одна осцилляция отвечает толщине пленки в два монослоя. Причину этого они видят в различии дифрагирования на поочередно меняющихся реконструкциях поверхности (2x1) и (1x2), из-за присутствия выделенного направления в геометрии островков на этих поверхностях.
Многие авторы считают, что при двумерно-слоевом росте один период осцилляции зеркально отраженного пучка электронов точно соответствует одному (или двум для соответствующего азимута Si(100)) монослою пленки выросшей за это время.
Авторы экспериментально и компьютерным моделированием показали, что на поверхности Si(001) при неизменном потоке атомов на подложку период осцилляций увеличивается с увеличением температуры роста. Объяснение этого явления состояло в том, что при повышении температуры большая часть атомов начинает встраиваться в ступени, выбывая тем самым из процессов периодического изменения шероховатости поверхности, поэтому к моменту срастания островков, т.е. за один период осцилляции, вырастает пленка толщиной более монослоя.
Другие исследователи утверждали противоположное. В [29] была предложена модель процесса роста кристалла, из которой следует, что в области перехода от двухмерно-слоевого к ступенчато-слоевому механизму роста период осцилляций уменьшается с увеличением температуры роста. В работе [30] авторы измерили температурную зависимость периода осцилляций для Geна Ge(111). Полученные ими данные хорошо согласуются с моделью [29] и компьютерным моделированием. То есть при увеличении температуры подложки за время одной осцилляции должна вырастать пленка меньше монослоя.
Целью этой работы является исследование возможных механизмов влияющих на величину периода осцилляций.
Методика эксперимента
Разрешение вопроса о соответствии одного периода осцилляций пленке монослойной толщины, возможно путем независимого измерения периода осцилляций и скорости осаждения материала на поверхность. Анализируя температурную зависимость отклонения толщины пленки от монослоя, можно понять механизмы вызывающие это отклонение.
В данной работе измерена температурная зависимость толщины пленки кремния и германия на слабо разориентированой поверхности кремния (111). Эксперимент проводился на установке "Катунь-С", оснащенной электронно-лучевыми испарителями Si и Ge. Регистрация ДБЭ-осцилляций осуществлялась с помощью системы "Фотон-микро". Скорость роста германия и кремния в экспериментах составляла 0.02 нм/сек. Для сопоставления периода осцилляций с толщиной напыляемой пленки, во время роста измерялась скорость потока. Измерения производились кварцевым измерителем толщины, одновременно с регистрацией осцилляций. Сочетание этих двух методов позволило определить эффективную толщину эпитаксиальной пленки, выросшей за время, соответствующее периоду ДБЭ-осцилляций.
Для повышения удобства и точности измерений скорости осаждения, мной была разработана и собрана электронная схема, позволяющая передавать текущие значения показаний прибора в компьютер. И написана программа для чтения, обработки и хранения измеренных данных.
Установка молекулярно-лучевой эпитаксии «Катунь»
Автоматизированная многокамерная установка молекулярно-лучевой эпитаксии "Катунь" предназначена для получения многослойных эпитаксиальных пленочных структур в условиях сверхвысокого вакуума. Схема используемой в работе части установки показана на рисунке 2.

Рисунок 2.
Схема экспериментальной установки.
1) Люминесцентный экран.
2) Криопанель.
3) Нагреватель.
4) Манипулятор.
5) Рейка для транспортировки подложек.
6) Шибер.
7) Камера МЗВ.
8) Манипулятор с кассетами.
9) Система регистрации ДБЭ - «Фотон-микро».
10) Кварцевый измеритель толщины
Основные части которой включают в себя: модуль загрузки-выгрузки, транспортный узел и модуль эпитаксии моноатомных полупроводников.
Модуль загрузки-выгрузки (МЗВ) предназначен для загрузки, выгрузки и транспортировки полупроводниковых подложек в сверхвысоковакуумную установку. В модуле так же производится первичное обезгаживание подложек. МЗВ состоит из вакуумной камеры, вакуумных насосов, двух манипуляторов с кассетами для подложек, натекателя и датчиков давления. Модуль позволяет одновременно загрузить 20 подложек диаметром до 100 мм.
Транспортный узел предназначен для перемещения рейки с подложками из МЗВ в камеру роста.
Модуль эпитаксии моноатомных полупроводников позволяет производить эпитаксиальный рост моноатомных полупроводников, тугоплавких металлов и осуществлять легирование в процессе роста. Модуль содержит в себе следующие устройства: вакуумная камера, система насосов, манипулятор с нагревателем, блок испарителей, датчик масс-спектрометра, криопанель, датчики давления, дифрактометр быстрых электронов, кварцевый измеритель толщины.
Вакуумная система нужна для создания необходимого рабочего давления в модулях и состоит из насосов форвакуумного, адсорбционного, сублимационного и магниторазрядного, обеспечивая предельное остаточное давление 1*10-8
Па.
Манипулятор с нагревателем предназначен для захвата подложки и ориентировки ее относительно молекулярных пучков и аналитических приборов, а также для нагрева и вращения подложки во время эпитаксии. Нагрев подложки осуществляется тепловым излучением нагревателя, который окружен системой многослойных экранов для уменьшения излучения на стенки камеры. Максимальная температура нагрева подложек 1100 С.
Блок испарителей является одним из основных узлов технологических модулей и предназначен для получения молекулярных пучков. Блок включает в себя два электронно-лучевые испарители (ЭЛИ) Ge и Si, две молекулярных ячейки Кнудсена Sb и B2
O3
и криопанель. ЭЛИ позволяет получать молекулярные потоки веществ, имеющих высокую температуру испарения или требующих испарения из автотиглей из-за большой химической активности. Ячейки Кнудсена создают молекулярный поток за счет нагрева тигля с испаряемым веществом. Конструкция ячеек позволяет получать температуры на тигле испарителя в диапазоне 0-1300 С, с точностью поддержания температуры 0.5 С.
Электронно-лучевой испаритель
Из-за большой химической активности кремния и германия, для получения пленок с минимальным количеством ненужных примесей встает необходимость использования «автотигей» для получения чистых атомных пучков этих материалов. Использование электронно-лучевого испарителя решает эту проблему.
Основные части ЭЛИ включают в себя катод, фокусирующий электрод, ускоряющий электрод и мишень (испаряемый материал). Поворот и фокусировка электронного пучка в центр мишени производится постоянным магнитным полем самарий-кобальтовых магнитов, укрепленных под корпусом испарителя. Кристаллическая мишень (кремниевая или германиевая) размещена в водоохлаждаемом корпусе. Поток электронов разогревает центральную часть кристалла до плавления.
Применение магнитного поля для фокусировки электронного пучка позволяет сделать катодный узел невидимым из места расположения подложек. Тем самым устраняется опасность прямого попадания продуктов ионного распыления на подложку и эпитаксиальную пленку.
Скорость осаждения можно изменять управляя мощностью электронной бомбардировки, изменяя величину «озера» расплавленного материала. Для предотвращения загрязнения испаряемого материала это «озеро» не должно выходить за границу кристалла, т.е. сам кристалл является тиглем и, таким образом, реализуется режим «автотигля». Управление мощностью осуществляется изменением тока эмиссии при неизменном ускоряющем напряжении.
При длительной работе ЭЛИ в центре материала, загруженного в тигель, образуется кратер, что может привести к уменьшению скорости испарения и увеличению неравномерности толщины пленки. Для выравнивания профиля загруженного материала центр расплава временно смещают в разные стороны от центра тигля, оплавляют края кратера и таким образом перемещают испаряемый материал к центру тигля. Смещение центра расплава производят изменением ускоряющего напряжения или внешними магнитами, размещенными на стенке вакуумной камеры.
Дифрактометр быстрых электронов
Дифрактометр быстрых электронов предназначен для наблюдения структуры тонких пленок в процессе их нанесения методом МЛЭ, а так же для наблюдения структуры поверхности подложек в процессе предэпитаксиальной подготовки.
Действие дифрактометра основано на формировании дифракционной картины в результате отражения от поверхности исследуемого вещества. Электронный луч, сформированный электронной пушкой и магнитной линзой, попадает на образец и, отражаясь от него, попадает на люминесцентный экран.
Контроль интенсивности зеркально-отраженного пучка электронов осуществлялся с помощью системы «Фотон-микро». Система регистрации включает в себя телекамеру, блок управления и может выполнять следующие функции:
-отображение дифракционной картины с люминесцентного экрана на экран видеоконтрольного устройства;
-выбор точек слежения за яркостью картины;
-вывод на самописец кривых изменения яркости дифракционной картины в указанных точках.
Кварцевый измеритель толщины
Использование кварцевого измерителя толщины позволяет независимо от ДБЭ измерять толщину напыляемой пленки. Физический принцип прибора основан на измерении изменения периода собственных колебаний кварцевой пластинки (резонатора).
Измерительный резонатор, помещенный в вакуумный объем напылительной установки, определяет период колебаний выносного генератора. Собственный период колебаний измерительного резонатора прямо зависит от толщины пленки, осаженной на него. Сравнивая период колебаний выносного генератора с эталонным, можно определить толщину выросшей пленки.
В данной работе использовался цифровой прибор УУП-1, предназначенный для контроля толщины и скорости роста пленок алюминия, поэтому частота внутреннего генератора подобрана так, чтобы изменение показаний прибора на единицу соответствовало толщине пленки алюминия в один ангстрем.
Градуировка прибора для измерения толщин пленок кремния и германия производилась при достаточно низких температурах эпитаксии в условиях двумерно-островкового роста, когда за один период осцилляции вырастает пленка монослойной высоты.
Подготовка образцов
Предэпитаксиальная очистка поверхности кремния является стандартной процедурой, которой пользуются большинство групп занимающихся эпитаксией на кремнии и проводится в три этапа:
1) Химическая очистка:
Пластина кремния равномерно окисляется на толщину порядка 1нм раствором H2
O2
+NH4
OH+H2
O.Затем с поверхности пластины удаляется оксидный слой SiO2
плавиковой кислотой (HF) во фторопластовой посуде. После чего производится тщательная промывка в деионизованой воде и сушка в ацетоне. После химической обработки на поверхности остается тонкий (несколько монослоев) и чистый от примесей слой оксида кремния SiO2
.
2) Удаление оксида кремния:
Температура подложки устанавливается порядка 800°C (вблизи точки сверхструктурного перехода Si(111)-7x7ÛSi(111)-1x1 при 830°C). После чего проводится подпыление поверхности пластины кремнием, с целью восстановления двуокиси кремния до моноокиси, которая при данной температуре десорбирует с поверхности. Поток кремния в процессе очистки составляет 5x1013
ат/см2
сек. При этом ведется наблюдение дифракционной картины поверхности подложки. При нормальном ходе процесса очистки, по истечении около двух минут начинает исчезать диффузный фон, и увеличивается яркость основных рефлексов. Завершение процесса очистки отличается появлением сверхструктурных рефлексов Si(111)-7x7.
3) Рост буферного слоя:
Для сглаживания макронеровностей оставшихся после шлифовки и предыдущих этапов обработки поверхности выращивается буферный слой кремния толщиной порядка 100нм. Температура поверхности устанавливается около 600°C. Рост осуществляется в течении пяти-семи минут со скоростью осаждения 1015
ат/см2
сек.
Данная система подготовки поверхности производится один раз.
Перед каждым новым ростом пластина прогревалась при температуре 1100°C в течении пяти минут и охлаждалась естественной теплоотдачей (без принудительного охлаждения) со скоростью около 20°C/сек (при высоких температурах) до температуры последующего роста.
Полученная таким образом поверхность представляет собой последовательность террас, разделенных ступенями моноатомной высоты, с направлением ступеней в направлении разориентации среза поверхности.
Проводя однообразно прогрев и охлаждение перед каждым экспериментом, мы предполагаем, что перед каждым новым ростом поверхность имеет одинаковую геометрию (высоты и направлений ступеней, разброс ширин террас) и такие же энергетические характеристики. О чем свидетельствует характерная дифракционная картина (7х7) реконструированной поверхности (рис.3), наблюдаемая после всех предэпитаксиальных подготовок.

Рисунок 3 Характерная картина ДБЭ поверхности Si(111)-7x7
Результаты эксперимента.
1. Поведение формы осцилляций от температуры.
В работе исследован методом ДБЭ рост слоев кремния на кремнии в диапазоне температур от 300 до 680°C
На рисунке 4 показано характерное поведение осцилляций при различных температурах эпитаксии кремния на поверхности Si(111)-7x7.

Рисунок 4 Осцилляции интенсивности ДБЭ при эпитаксии Si на Si(111)
При низких температурах эпитаксии наблюдается отсутствие первого максимума осцилляций. Зарождение островков происходит предпочтительно на метастабильных реконструкциях и дефектах поверхности уже образовавшихся островков, поэтому на идеальной поверхности (7х7) второй монослой начинает образовываться задолго до завершения первого, а затем рост происходит послойно.
Для высоких температур адатомы имеют более высокую энергию, вследствие чего они становятся менее чувствительны к поверхностным дефектам и метастабильным реконструкциям, поэтому рост идет помонослойно начиная с первой осцилляции.
Чувствительность зарождающихся островков к поверхностным дефектам так же наблюдается для эпитаксии германия.
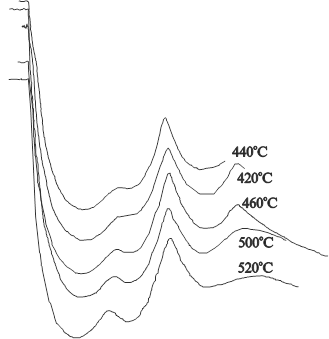
Рисунок 5 Осцилляции интенсивности ДБЭ при эпитаксии Ge на Si(111)
Методом ДБЭ, так же исследован рост слоев германия на кремнии в диапазоне температур от 300 до 500О
С. Поначалу рост осуществляется по двумерно-островковому механизму, о чем свидетельствуют осцилляции интенсивности зеркального рефлекса (рис.5). При толщине пленки более трех монослоев (МС) осцилляции прекращаются и интенсивность выходит на стационарное значение. С четвертого слоя начинают образовываться трехмерные островки (механизм Странского-Крастанова), о чем свидетельствует характерная дифракционная картина объемной дифракции (вместо тяжей от плоской поверхности появляются рефлексы).
На рисунке 5 показано характерное поведение осцилляций при различных температурах эпитаксии германия на поверхности Si(111)-7x7. Для всех представленных температур эпитаксии первый максимум осцилляции не наблюдается. Амплитуда второй осцилляции увеличивается с повышением температуры роста, аналогично первой осцилляции для кремния. После роста первого монослоя меняется реконструкция поверхности 7х7-5х5. Реконструкция 5х5 является стабильной для поверхности Ge(111) Поэтому можно заключить, что первый монослой германия повторяет структуру поверхности, перестраивается, после чего рост идет аналогично гомоэпитаксиальному и на величину амплитуды второй осцилляции в случае эпитаксии германия влияют те же механизмы, что и для эпитаксии кремния.
Третий максимум осцилляций с повышением температуры уменьшается и уширяется. Связано это с тем, что с повышением температуры уменьшается эффективная толщина пленки, начиная с которой осуществляется трехмерный рост.
2. Температурная зависимость толщины пленки вырастающей за один период осцилляции ДБЭ.
На рисунках 6 и 7 представлены температурные зависимости толщины эпитаксиальной пленки кремния, вырастающей за один период осцилляции интенсивности зеркально-отраженного пучка быстрых электронов, для различных образцов Si(111).

Рисунок 6 Температурная зависимость толщины пленки Siвырастающей за один период осцилляции

Рисунок 7 Температурная зависимость толщины пленки Siвырастающей за один период осцилляции
Скорость осаждения кремния в различных экспериментов изменялась в силу нестабильности длительной работы ЭЛИ, и колебалась в пределах 0.1±0.05 монослоя в секунду (1 монослой = 0.314 нм). За время проведения одного эксперимента (одной точки на графике) скорость потока атомов на подложку можно считать постоянной.
Для выяснения влияния скорости роста на точность экспериментов, измерена зависимость толщины пленки, вырастающей за один период осцилляции от скорости осаждения при постоянной температуре. На рисунке 8 представлена эта зависимость при температуре роста 500°C.
Как видно из зависимости, в диапазоне изменения скоростей 0.1±0.05 мс/сек., влиянием различия скоростей роста в разных экспериментах можно пренебречь, считая при этом скорость осаждения постоянной (хотя при вычислении толщины пленки берется точное значение скорости). Влияние скорости осаждения на толщину пленки так же представляет интерес, но в данной работе этот вопрос не рассматривается.

Рисунок 8 Зависимость толщины пленки вырастающей за один период осцилляции от скорости роста при 500 o
C
На рисунках 9 и 10 представлены характерные температурные зависимости толщины эпитаксиальной пленки германия на кремнии вырастающей за один период осцилляции.
Точность экспериментов для эпитаксии германия несколько ниже, по сравнению с кремнием из-за неточности определения периода. Для эпитаксии кремния период определялся путем измерения времени десяти осцилляций и делении его на их количество. При этом изменение периода с номером осцилляции в пределах точности не обнаружено. Для эпитаксии германия период определялся по второму пику осцилляции, так как третий максимум может быть смещен из-за близости перехода режима роста к трехмерному.
молекулярный эпитаксия кремний пленка
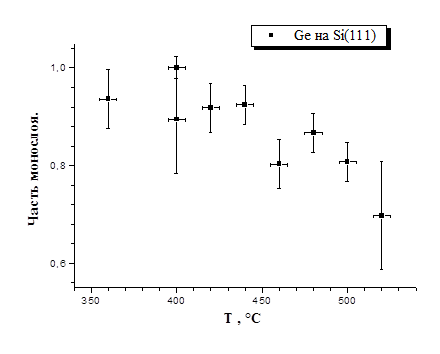
Рисунок 9 Температурная зависимость толщины пленки Geвырастающей за один период осцилляции

Рисунок 10 Температурная зависимость толщины пленки Geвырастающей за один период осцилляции
Обсуждение результатов температурной зависимости
Как видно из вышеуказанных зависимостей, при высоких температурах эпитаксии толщина пленки вырастающей за один период осцилляции ДБЭ не соответствует одному монослою, и максимальное отклонение достигает 25%. С увеличением температуры величина отклонения растет и достигает максимального значения в области температур перехода от двумерно-островкового к ступенчато-слоевому механизму роста. Дальнейшее увеличение температуры приводит к исчезновению осцилляций.
При этом для одних образцов зависимость идет вниз, т. е. при повышении температуры вырастает пленка эффективной толщиной меньшей монослоя, а для других, зависимость растет, что соответствует пленки с эффективной толщиной более монослоя. Причем характер поведения зависимостей для эпитаксии кремния и германия на одних и тех же образце одинаковый.
Кривые с уменьшением эффективной толщины пленки от температуры хорошо описываются в рамках модели роста, используемой в работе [30]. Хотя в данной упрощенной модели не учтена форма двумерных островков и предполагается равновероятным встраивание адатома в ступень снизу и сверху, она качественно объясняет причину изменения периода осцилляций.
В начальный момент времени, который на рисунке 10 соответствует положению (0) двумерных островков нет, шероховатость минимальна и интенсивность зеркального пучка имеет максимальное значение. После начала роста на террасе формируются двумерные островки, зарождающиеся на расстоянии равном удвоенной длине миграции адатомов (l) как друг от друга, так и от края ступени. В процессе роста двумерные островки разрастаются, а край ступени перемещается в сторону роста с той же скоростью, что и край островка. В момент времени (2) шероховатость максимальна и интенсивность зеркального рефлекса имеет минимум. При срастании двумерных островков края ступеней и двумерных островков продвинуться на расстояние, равное длине миграции адатомов l. Это соответствует состоянию поверхности, показанной для случая (4) на рис.11. Интенсивность зеркального рефлекса снова достигнет максимально значения, но край ступени не будет совпадать с начальным положением.

Рисунок 11 Модель роста для случая уменьшения толщины пленки при повышении температуры
Таким образом, за время, равное периоду осцилляций, край ступени переместится на расстояние, которое меньшее длины террасы на величину, равную длине миграции. Перемещение края ступени на величину (l-l) соответствует росту пленки с эффективной толщиной менее одного монослоя.
Для объяснения прямо противоположного поведения зависимости было замечено, что: согласно публикациям существует разница в зарождении островков и миграции адатомов для различных направлений ступеней на поверхности кремния (111). Так согласно [31], при газофазной эпитаксии Siна Si(111) для ступени[`1`1 2] на верхней террасе, зародившиеся у края ступени островки, не имеют зоны обеднения с этой ступенью. Однако присутствие водорода на растущей поверхности в методе газофазной эпитаксии может изменить энергетику поверхности по сравнению с ростом методом МЛЭ.
Отличие для миграции адатомов через ступени связано с существованием барьера Швебеля - дополнительного энергетического барьера для перехода адатома с верхней террасы на нижнюю. По расчетам для ступеней на поверхности Si(111)-(1х1) эти барьеры составляют 0.16±0.07 и 0.61±0.07 эВ для и соответственно.
При меньшем барьере, из-за наличия стока на ступенях, равновесная концентрация адатомов, в начальный момент роста, сильно спадает к границам ступеней, поэтому, при зарождении островков, между образовавшимися островками и ступенью существует область обеднения островков. Наличие большого энергетического барьера приводит к тому, что концентрация адатомов на верхней террасе вблизи края ступени остается большой, вследствие чего идет зарождение островков вблизи верхнего края ступени.
Исходя из этих соображений, предложена модель (рис.12), объясняющая рост температурной зависимости толщины пленки.
В данном случае часть островков зарождается на краю ступени. К моменту срастания (случая 4 на рис.12) край ступени переместится на расстояние, которое больше длины террасы на величину, равную длине миграции.

Рисунок 12 Модель роста для случая увеличения толщины пленки при повышении температуры
Для проверки данного предположения, методом рентгено структурного анализа была измерена разориентация поверхности образцов. Для различных образцов разориентация менялась от 6 до 10 минут. К нашему глубокому сожалению, определить направление разориентации данным методом не удалось, в силу очень малых углов разориентации.
Величина, характеризующая уменьшение или увеличение периода ДБЭ осцилляций, определяется длиной миграции адатомов, которая может быть вычислена по формуле:
L´(1-d/d111
) - для случая роста пленки толщиной меньше монослоя (за один период), и L´(d/d111
-1) - для случая роста пленки большей монослоя
Где L - ширина террасы, в - эффективная толщина пленки, d111
- толщина монослоя (d/d111
=доля монослоя). Таким образом, по изменению периода осцилляций, зная угол разориентации подложки, можно определить значения l.
Однако существует ограничение на применимость этой формулы при близких значениях dи d111
, в связи с большим увеличением погрешности определения при стремлении к нулю. Поэтому предел применимости можно записать как: /L>(относительная погрешность измерения d).
В обоих случаях максимальное значение эффекта составляет 25%, что соответствует =L/4. При больших значениях рост осуществляется по ступенчато-слоевому механизму, что ведет к исчезновению осцилляций.
Процессы участвующие в зарождении островков носят активационный характер, поэтому по температурной зависимости толщины пленки, вырастающей за один период, можно определить характеристическую энергию процесса зарождения островков. Строя температурные зависимости в Арениусовых координатах находится энергии активации процесса образования двумерных зародышей Em
.
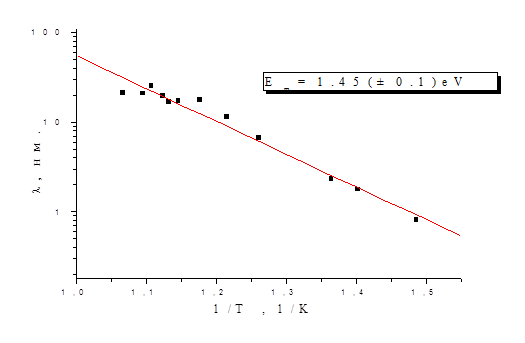
Рисунок 13 Зависимость длинны миграции адатомов Siна Si(111) от обратной температуры (данные рис.6)

Рисунок 14. Зависимость длинны миграции адатомов Siна Si(111) от обратной температуры (данные рис.7)
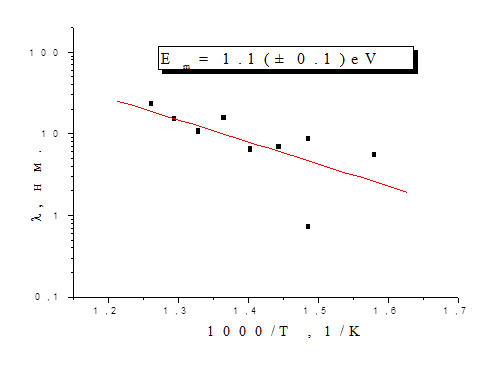
Рисунок 15 Зависимость длинны миграции адатомов Geна Si(111) от обратной температуры (данные рис.9)
+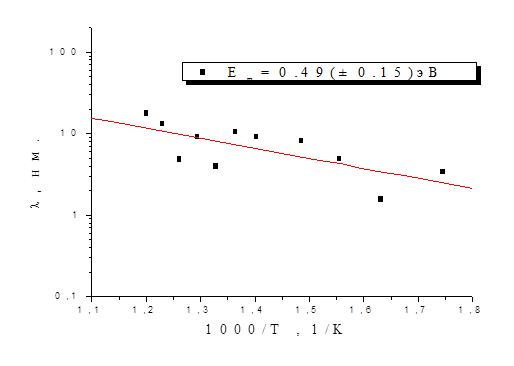
Рисунок 16 Зависимость длинны миграции адатомов Geна Si(111) от обратной температуры (данные рис.10)
На рисунках 13-16 представлены графики зависимости длинны миграции для систем Si/Si(111) и Ge/Si(111). При этом для первого образца энергия активации длинны миграции составила 1.45±0.1 эВ при эпитаксии кремния и 1.1±0.1 эВ при эпитаксии германия. Для второго образца энергия активации составила 0.91±0.1 эВ при эпитаксии кремния и 0.49±0.1 эВ при эпитаксии германия.
Миграции адатомов определяется коэффициентом поверхностной диффузии и величиной падающего потока. Энергия активации формирования двухмерных островков складывается из энергии активации поверхностной диффузии и энергии образования двумерного зародыша. Кроме того имеет существенное значение минимальное количество атомов, которые образуют этот зародыш. Поэтому полученное значение энергии активации миграции адатомов связать однозначно с энергией активации поверхностной диффузии и величиной потока атомов на поверхность можно только с учетом указанных параметров. Но они неизвестны для исследуемой нами системы.
Однако, т.к. поток атомов на поверхность, температура эпитаксии, последовательность подготовки образцов - одинаковы, плюс близкое значение углов разориентации, поэтому можно предположить, что энергия активации поверхностной диффузии, размер и энергия образования двумерных зародышей одинакова для этих образцов. Возникает вопрос, с чем связано отличие в активационных энергиях для различных образцов?
Заметим что, для эпитаксии кремния и германия, отличие активационных энергий разных образцов в пределах точности совпадает (0.4 эВ).
Поэтому мы предполагаем, что это отличие связано с разницей барьеров для миграции адатомов через ступень для различных ступеней. Разница барьеров Швебеля по расчетам [32] для ступеней [-211] и [-1-12] на поверхности Si(111)-(1х1) составляет 0.45 эВ. Однако данные расчеты приведены для (1х1) реконструкции поверхности, а в наших экспериментах хорошо наблюдалась реконструкция (7х7) которая может несколько изменить значения этих барьеров.
Выводы
По результатам проведённых исследований измерения температурной зависимости толщины эпитаксиальной пленки, при молекулярно-лучевой эпитаксии на Si(111) можно сделать следующие выводы:
1). Проверено, что период осцилляции зеркально отраженного пучка быстрых электронов не всегда соответствует росту пленки монослойной толщины, и это несоответствие может достигать 25% в области температур перехода от двумерно-островкового к ступенчато-слоевому механизму роста.
2). Измерена температурная зависимость толщины пленки, вырастающей за один период осцилляции при молекулярно-лучевой эпитаксии кремния и германия на слабо отклоненной поверхности Si(111).
3). Обнаружено, что с повышением температуры эффективная толщина пленки вырастающей за один период осцилляции может как увеличиваться, так и уменьшаться.
4). Предложена модель, объясняющая возможность различного поведения полученных температурных зависимостей эффективной толщины пленки.
5). Определена энергия активации длинны миграции адатомов на поверхности, которая составила при эпитаксии кремния 1.45±0.1 эВ и 0.91±0.1 эВ, при эпитаксии германия 1.1±0.1 эВ и 0.49±0.1 эВ для образцов с различным поведением температурных зависимостей соответственно.
Благодарности
Выражаю огромнейшую благодарность моему научному руководителю к.ф.-м.н. Никифорову А.И. за частые обсуждения вопросов непосредственно связанных с моей дипломной работой, за поощрение и помощь при проявлении мной инициативных начинаний, а так же за дружественный дух который царит в его рабочей группе.
Хочу поблагодарить так же к.ф.-м.н. Маркова В.А. за полученные от него знания и начальные навыки работы на установке молекулярно-лучевой эпитаксии.
Хочу сказать большое спасибо аспиранту Колесникову .. за проведенные им измерение углов разориентации образцов.
Особенно хочу поблагодарить к.ф.-м.н. Чикичева С.И. за интересные, занимательные спецсеминары и систематическую стимуляцию написания дипломной работы.
Cписок литературы
1. Г.А. Абдурагимов «Поверхность кристалла и эпитаксия» Издательство Ростовского Университета Ростов-на-Дону 1987г.
2. Б.З. Кантер, А.И. Никифоров, В.П. Попов «Исследование сверхрешеток на основе слоев Sb, полученных с помощью МЛЭ кремния, методом резерфордовского обратного рассеяния»//«Полупроводники» Сборник научных трудов ВО «Наука» Новосибирск 1993 стр.81
3. «Спектроскопия и диффракция электронов при исследовании поверхности твердых тел» Москва, Наука 1985
4. Physical Review Letters v.74 №14 1995 p.2756
5. B.Voigtlander, M.Kastner «’’In vivo’’ STM studies of the growth Germanium and Silicon on Silicon» // Appl. Phys. A 63,577-581(1996)
6. Bert Voigtlander and Thomas Weber «Nucleation and growth of Si/Si(111) observed by scanning tunneling microscopy during epitaxy» // Physical Review B v.54 №8 p.1-4
7. Bert Voigtlander, Andre Zinner and Thomas Weber «High temperature scanning tunneling microscopy during molecular beam epitaxy» // Rev.Sci.Instrum. 67(7),July 1996 p.2568-2572
8. Э.Зенгуил «Физика поверхности» Москва «Мир» 1990г.
9. В.А. Зиновьев, В.Ю. Баландин, Л.Н. Александров «Скорость движения ступеней при росте поверхности (111) в условиях сверхструктурного фазового перехода (7х7)-(1х1)»//«Полупроводники» Сборник научных трудов ЦЭРИС Новосибирск 1994 стр.219
10. Y.-N. Yang and E.D. Williams «High atom density in the (1x1) phase of metastable reconstruction on Si(111)» // Physical review Letters v.72 №12(1994) 1862-1865
11. Л.С. Палатник, И.И. Папиров «Эпитаксиальные пленки» Москва «Наука» 1971г.
12. M.Ichikawa and T.Doi «Microprobe Reflection High-Energy Electron Diffraction» // RHEED and Reflection Electron Imagine of surfaces 1988 p.343-369
13. U. Kohler, J.E. Demuth and R.J. Hamers «Scfnning tunneling microscopy study of low-temperature epitaxial growth of silicon on Si(111)-(7x7)» // J.Vac.Sci.Thecnol. A 7(4),Jul/Aug 1988 2860-2866
14. Bert Voigtlander, Andre Zinner, Thomas Weber and Hans P.Bonzel «Modification of growth kinetics is surfactant mediated»//Physical Review B v.51 №.12(1995) pp.7583-7591
15. А.В. Латышев, А.Б. Красильников, А.Л. Асеев «Структура анти-эшелонов ступеней на вицинальной поверхности Si(111) в условиях нагрева пропусканием электрического тока» «Полупроводники» Сборник научных трудов ЦЭРИС Новосибирск 1994 стр.197
16. M. Horn Von Hoegen, J. Falta and M. Henzler «The initial stages of growth of silicon on Si(111) by slow positron annihilation low-energy electron diffraction» Thin Solid Films,183(1989) 213-220
17. Mats I. Larson and Goran V. Hanson «Initial stages of Si molecular beam epitaxy studied with Reflection High-Energy Electron Diffraction intensity measurement and Monte Carlo simulations» J.Crystal Growth 134,203(1993) 151 160
18. Michael Horn-von Hoegen, Holger Pietsch «Homoepitaxy of Si(111) is surface defect mediated» // Surf.Sci.Lett. 231(1994) L129-L136
19. V.A. Markov, A.I. Nikiforov and O.P. Pchelyakov «In situ RHEED control of direct MBE growth of Ge quantum dots on Si(001)» // J.Crystal Growth 175/176(1997) 736-740
20 Toshino Ogino «Self-organization of nanostructures on Si wafers using surface structure control» // Surface Science 386(1997) pp.137-148
21. «Современная кристаллография. Том 3. Образование кристаллов.» Чернов А.А., Гиваргизов Е.И. и др. Москва, Наука 1980г.
22. Katusuyuki Shoji «Heteroepitaxial growth and superstucture of Ge on Si(111)-(7x7) and Si(100)-(2x1) surfaces» // Japanese Journal of Applied Physics v.22 №.10 (1983)pp.1482-1488
23. J.H.Neave, P.J.Dobson, B.A.Joyce and Jing Zhang «Reflection High-Energy Electron Diffraction oscillation from vicinal surfaces-a new approach to surfaces diffusion measurement» Appl.Phys.Lett. 47(2) 15July 1985 p.100-102
24. V.A. Markov, L.V. Sokolov, O.P. Pchelyakov Surf.Sci. 1991 v.250 p.229-234
25. М.А. Ламин, В.И. Машанов, О.П. Пчеляков «Осцилляции интенсивности ДБЭ от поверхности Si(111) в присутствии поверхностного резонанса» «Полупроводники» Сборник научных трудов ЦЭРИС Новосибирск 1994 стр.208
26. Tsunenori Sakamoto «RHEED oscillation in MBE their application to precisely controlled crystal growth» // Physic fabrication and application of multilayer structures p.93-110
27. Tsunenori Sakamoto, Kunihiro Sakamoto, Satoru Nagao and sw. «RHEED intensity oscillation-an effective tool of Si and Gex
Si1-x
MBE» // Thin film growth techniques for low-dimensional structures p.225-245
28. H.J.W.Zandvliet, H.B.Elswijk, D.Dijkkamp and etc. «On the period of Reflection High-Energy Electron Diffraction intensity oscillation during Si molecular beam epitaxy on vicinal Si(001)» // J.Appl.Phys. 70(5), 1 september 1991 pp.2614-2617
29. O.P. Pchelyakov, I.G. Neisvestnyi, Z.Sh. Yanovitskaya «RHEED control of nanostructure formation durig MBE»// Phys.Low-Dim.Struct., 1995, v.10/11,389-396.
30. A.I. Nikiforov, V.A. Markov, O.P. Pchelyakov and Z.Sh. Yanovitskaya «The influensce of the Epitaxial Growth Temperature on the Period of RHEED Oscillations» Phys. Low-Dim. Struct., 7(1997) pp.1-10.
31. M. Fehrenbacher, H. Rauscher, U. Memmert, R.J. Behm «SiH4
chemical vapor deposition on Si(111)-( 7 Ч7) studied byscanning tunneling microscopy» // Surface Science 385 ( 1997) 123–145
32. S. Kodiyalam, K. E. Khor and S. Das Sarma «Calculated Schwoebel barriers on Si(111) step using an empirical potential» // Physical Review B v.53 №.15 (1995) pp.9913-9922.
33. «Молекулярно-лучевая эпитаксия и гетероструктуры» под ред.Л.Ченг и К.Полога - Москва 1989г.
34 Toshihiro Ichikawa and Shozo Ino «RHEED study on the Ge/Si(111) and Si/Ge(111) systems: reaction of Ge with the Si(111)-(7x7) surfaces» // Surface Science 136(1984) pp.267-284
|